BGA焊点的形态预测及可靠性优化设计
周文凡,田艳红,王春青
(哈尔滨工业大学现代焊接生产技术国家重点实验室,黑龙江 哈尔滨 150001)
摘 要:制定了BGA (球栅阵列)焊点的形态预测以及可靠性分析优化设计方案,对完全分布和四边分布的两种BGA元件,通过改变下焊盘的尺寸得到不同钎料量的焊点,并对其形态进行了预测,建立了可靠性分析的三维力学模型。采用有限元方法分析了元件和焊点在热循环条件下的应力应变分布特征,预测了不同种类和不同形态的BGA焊点的热疲劳寿命,由此给出了****的上下焊盘比例范围。
关键词:球栅阵列;焊点形态;有限元分析;可靠性;热疲劳寿命
集成电路的面封装技术中, BGA (Ball Grid Ar2ray - 球栅阵列)焊点的形态预测及可靠性优化设计是一个重要的问题。改善焊点可靠性的途径主要有改善钎料的力学性能、开发CTE匹配的材料、焊点形态优化设计及改善元件布局等。由于微组装焊点的几何尺寸很小,这使得采用实验测量方法的难度很大,而且会损耗大量的人力物力,因此有限元数值模拟方法得到了广泛的应用。
本文基于BGA焊点的形态预测以及可靠性分析优化设计方案,采用Surface Evolver软件预测了不同钎料量下BGA的焊点形态,利用MSC. MARC /MENTAT建立了热循环条件下BGA焊点的应力应变分析模型,并对焊点的疲劳寿命进行了预测。因为一般BGA封装件上的焊盘(上焊盘)直径对于用户是不可变更的,且并非上下焊盘尺寸一致是最好的选择,因此本文通过改变PCB板的焊盘(下焊盘)尺寸,经有限元分析寻找到对应****热循环疲劳寿命的BGA焊点结构。该结果对工程实践具有重要的实用价值。
1 分析对象及形态预测方案
本文的分析对象分别为完全分布BGA256元件(A)和四边分布BGA256元件(B ) ,其凸点材料均为Sn63Sn37, 凸点直径分别为0. 60 mm 和0. 75mm,凸点中心距分别为1. 0 mm和1. 27 mm。由于元件的凸点直径和印刷模板的厚度都已固定,因此只能通过改变印刷焊膏的直径即下焊盘直径来寻找****可靠性的焊点形态。对两种元件固定上焊盘直径,分别取五种不同的下焊盘直径,将凸点钎料量与印刷钎料量相加,可得相应的焊点体积。由此制定的焊点形态预测方案见表1。

2 Surface Evolver焊点形态预测结果
焊点形态预测结果示意图如图1所示。

焊点高度与****外径随焊点下焊盘尺寸变化曲线如图2所示。

可见,印刷模板厚度一定时,随着下焊盘尺寸的增加,焊点的高度逐渐减小,但****外径逐渐增加。
3 焊点有限元分析的力学模型
多次分析表明, BGA 元件的边角焊点最先失效,因此最终对斜对称面上的两个边角焊点进行细化处理,元件其他部分则采用较粗的网格划分。根据形态预测的结果,对不同钎料量的焊点的每个元件,分别取其实际结构进行有限元分析,由于对称性,取元件的1 /8进行模拟。完全分布BGA256元件焊点力学分析的有限元分析模型实例如图3 所示,四边分布BGA256元件焊点力学分析的有限元分析模型图4所示。元件关键焊点的有限元分析模型实例如图5所示。
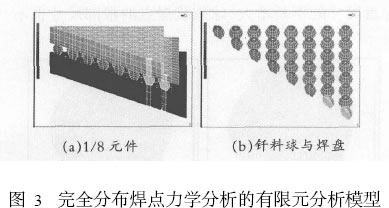
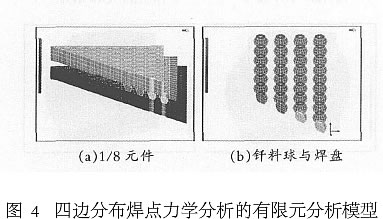
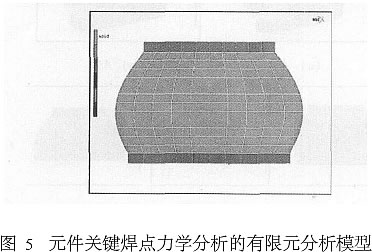

有限元分析采用的加载条件如图6所示,

温度范围T = - 55 ℃~125 ℃,高低温各保温10 min,升降温速率为4℃/min,热循环频率f = 13. 2 周期/天。零应力应变时的参考温度Tref = 27 ℃。有限元分析时一般进4个周期的计算。
Mold塑封材料、BT基板、Cu焊盘和FR4树脂基板的材料模式选用线弹性材料,并认为材料性能与温度无关,各向同性;对共晶SnPb钎料,其弹塑性材料性能与温度有关,本文采用文献[ 1~2 ]对钎料性能的定义:钎料的屈服应力σy = 33. 9 - 0. 145 ×T,其他材料参数见表2。

热循环载荷下, Sn63Pb37钎料的蠕变行为描述采用Darveaux的蠕变本构方程[ 1 ]:
 |
